掃描式電子顯微鏡
Scanning Electron Microscope
SEM是由電子槍(Electron Gun)透過熱游離或場發射原理產生高能電子束,經過幾組聚焦透鏡(Condenser Lens)的聚焦,並利用偏向線圈(Deflection Coils)偏折電子束,最後透過物鏡(Objective Lens)打在試片上。
在試片的側上方裝有偵測器,用以擷取二次電子(Secondary Electron)或背向散射電子(Backscattered Electron),從而獲得樣品信息來成像,它能產生樣品表面的高解析度圖像,常被用來鑒定樣品的表面結構。
本中心SEM除了可觀察樣品形貌外,亦可配合能量散射光譜儀(EDS)的輔助來進行成份分析。
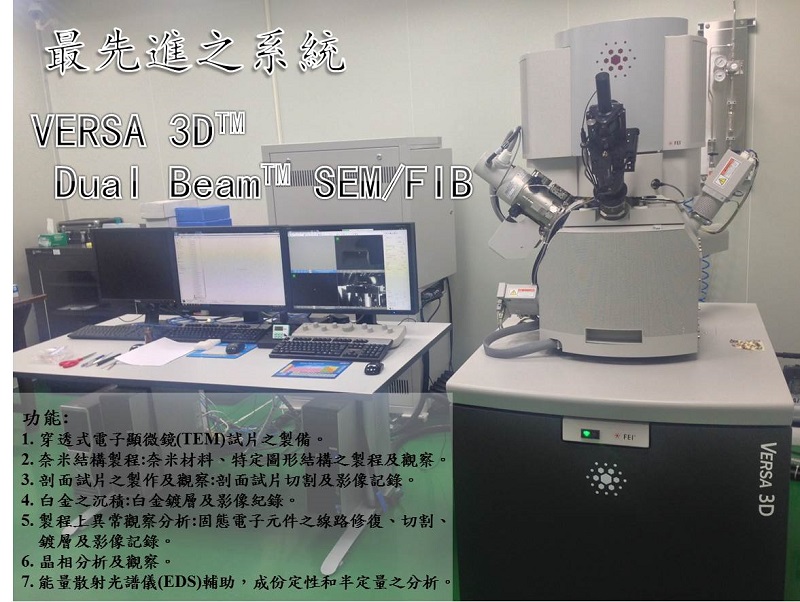 Fig.1 SEM主體外觀
Fig.1 SEM主體外觀
Fig.2 規格表
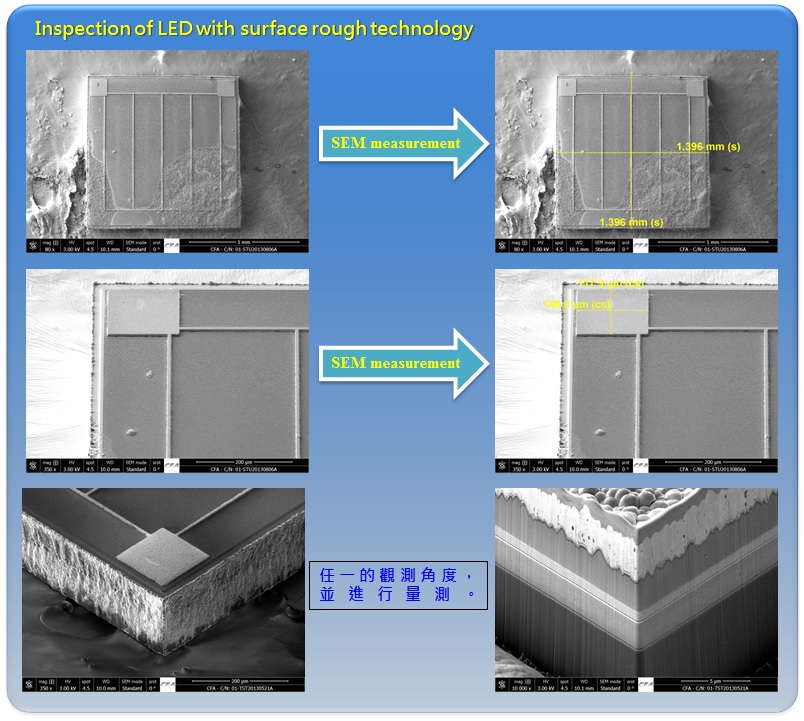
Fig.3 表面形貌分析與量測